Оборудование для лазерной отслаивания полупроводниковых материалов совершает революцию в утонении слитков.
Подробная схема
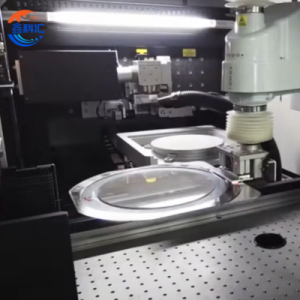
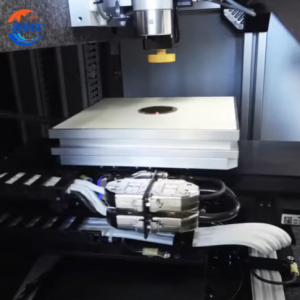
Представление продукции: оборудование для лазерной отслаивания полупроводниковых лазеров
Оборудование для лазерного отслаивания полупроводниковых пластин — это высокоспециализированное промышленное решение, разработанное для точного и бесконтактного утонения полупроводниковых слитков с помощью лазерно-индуцированных технологий отслаивания. Эта передовая система играет ключевую роль в современных процессах производства полупроводниковых пластин, особенно при изготовлении сверхтонких пластин для высокопроизводительной силовой электроники, светодиодов и радиочастотных устройств. Благодаря возможности отделения тонких слоев от объемных слитков или донорских подложек, оборудование для лазерного отслаивания полупроводниковых пластин совершает революцию в утонении слитков, исключая этапы механической распиловки, шлифовки и химического травления.
Традиционная технология утонения полупроводниковых слитков, таких как нитрид галлия (GaN), карбид кремния (SiC) и сапфир, часто является трудоемким, неэффективным и подверженным образованию микротрещин или повреждению поверхности. В отличие от этого, оборудование для лазерной подгонки полупроводниковых материалов предлагает неразрушающую, точную альтернативу, которая минимизирует потери материала и поверхностное напряжение, одновременно повышая производительность. Оно поддерживает широкий спектр кристаллических и сложных материалов и может быть легко интегрировано в производственные линии полупроводниковых предприятий на начальном или среднем этапе производства.
Благодаря настраиваемым длинам волн лазера, адаптивным системам фокусировки и вакуумно-совместимым зажимным устройствам для пластин, это оборудование особенно хорошо подходит для нарезки слитков, создания ламелей и отделения сверхтонких пленок для вертикальных структур устройств или переноса гетероэпитаксиальных слоев.

Параметры оборудования для лазерной отводной обработки полупроводниковых лазеров
| Длина волны | ИК/SHG/THG/FHG |
|---|---|
| Ширина импульса | Наносекунда, пикосекунда, фемтосекунда |
| Оптическая система | Стационарная оптическая система или гальванооптическая система |
| XY-платформа | 500 мм × 500 мм |
| Диапазон обработки | 160 мм |
| Скорость передвижения | Максимальная скорость 1000 мм/сек. |
| Повторяемость | ±1 мкм или менее |
| Абсолютная точность позиционирования: | ±5 мкм или менее |
| Размер вафли | 2–6 дюймов или на заказ |
| Контроль | Windows 10, 11 и ПЛК |
| Напряжение питания | Переменный ток 200 В ±20 В, однофазный, 50/60 кГц |
| Внешние размеры | 2400 мм (Ш) × 1700 мм (Г) × 2000 мм (В) |
| Масса | 1000 кг |
Принцип работы оборудования для лазерной отводной съемки полупроводниковых лазеров
Основной механизм работы оборудования для лазерной подгонки полупроводниковых материалов основан на селективном фототермическом разложении или абляции на границе раздела между донорным слитком и эпитаксиальным или целевым слоем. Высокоэнергетический УФ-лазер (обычно KrF с длиной волны 248 нм или твердотельные УФ-лазеры с длиной волны около 355 нм) фокусируется через прозрачный или полупрозрачный донорный материал, где энергия селективно поглощается на заданной глубине.
Это локальное поглощение энергии создает слой газовой фазы высокого давления или слой термического расширения на границе раздела, что инициирует чистое отслоение верхнего слоя пластины или устройства от основания слитка. Процесс точно настраивается путем регулирования таких параметров, как ширина импульса, плотность энергии лазера, скорость сканирования и глубина фокусировки по оси Z. В результате получается сверхтонкий срез — часто в диапазоне от 10 до 50 мкм — чисто отделенный от исходного слитка без механического истирания.
Этот метод лазерной шлифовки для утонения слитков позволяет избежать потери ширины пропила и повреждения поверхности, связанных с алмазной проволочной пилой или механической притиркой. Он также сохраняет целостность кристалла и снижает требования к последующей полировке, что делает оборудование для лазерной шлифовки полупроводников революционным инструментом для производства пластин следующего поколения.
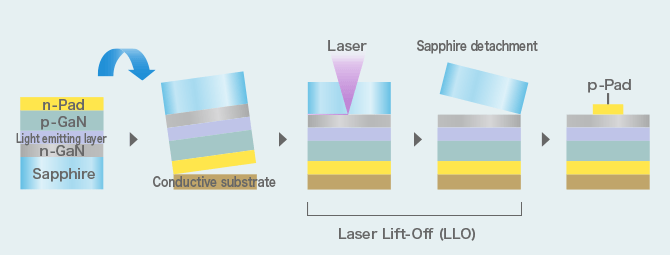
Применение оборудования для лазерной отслаивания полупроводниковых лазеров
Оборудование для лазерной обработки полупроводниковых материалов находит широкое применение в утонении слитков из целого ряда современных материалов и типов устройств, включая:
-
Уменьшение толщины слитков GaN и GaAs для силовых приборов
Позволяет создавать тонкие пластины для высокоэффективных силовых транзисторов и диодов с низким сопротивлением.
-
Восстановление подложки из карбида кремния и разделение ламелей.
Позволяет осуществлять отделение пластин от подложек из объемного карбида кремния для создания вертикальных структур устройств и повторного использования пластин.
-
Нарезка светодиодных пластин
Облегчает отделение слоев GaN от толстых сапфировых слитков для получения сверхтонких подложек для светодиодов.
-
Изготовление радиочастотных и микроволновых устройств
Поддерживает сверхтонкие структуры транзисторов с высокой подвижностью электронов (HEMT), необходимые в системах 5G и радиолокационных системах.
-
Эпитаксиальный перенос слоя
Обеспечивает точное отделение эпитаксиальных слоев от кристаллических слитков для повторного использования или интеграции в гетероструктуры.
-
Тонкопленочные солнечные элементы и фотоэлектрические устройства
Используется для разделения тонких поглощающих слоев в гибких или высокоэффективных солнечных элементах.
В каждой из этих областей оборудование для лазерной полировки полупроводников обеспечивает непревзойденный контроль над равномерностью толщины, качеством поверхности и целостностью слоев.
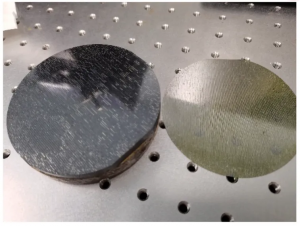
Преимущества лазерного утонения слитков
-
Потеря материала при нулевой ширине пропила
По сравнению с традиционными методами нарезки кремниевых пластин, лазерный процесс обеспечивает практически 100% использование материала.
-
Минимальное напряжение и деформация
Бесконтактное отслаивание исключает механическую вибрацию, уменьшая деформацию пластин и образование микротрещин.
-
Сохранение качества поверхности
Во многих случаях не требуется последующая притирка или полировка, поскольку лазерное удаление материала сохраняет целостность верхней поверхности.
-
Высокая производительность и готовность к автоматизации
Способна обрабатывать сотни субстратов за смену с автоматизированной загрузкой/выгрузкой.
-
Адаптируется к различным материалам
Совместимость с GaN, SiC, сапфиром, GaAs и перспективными материалами III-V группы.
-
Экологически безопаснее
Снижает использование абразивных материалов и агрессивных химикатов, характерных для процессов разбавления с использованием суспензий.
-
Повторное использование субстрата
Исходные слитки можно перерабатывать многократно в течение нескольких циклов отрыва, что значительно снижает затраты на материалы.
Часто задаваемые вопросы (FAQ) об оборудовании для лазерной отслаивания полупроводниковых лазеров
-
В1: Какой диапазон толщины пластин может обеспечить оборудование для лазерной подгонки полупроводниковых пластин?
А1:Типичная толщина среза составляет от 10 мкм до 100 мкм в зависимости от материала и конфигурации.В2: Можно ли использовать это оборудование для истончения слитков из непрозрачных материалов, таких как карбид кремния (SiC)?
А2:Да. Путем настройки длины волны лазера и оптимизации инженерии интерфейса (например, с помощью жертвенных промежуточных слоев) можно обрабатывать даже частично непрозрачные материалы.В3: Как выравнивается донорская подложка перед лазерным отслаиванием?
А3:Система использует модули выравнивания на основе субмикронного машинного зрения с обратной связью от реперных меток и сканирования отражательной способности поверхности.В4: Каково ожидаемое время цикла для одной операции лазерного отслаивания?
A4:В зависимости от размера и толщины пластины, типичный цикл длится от 2 до 10 минут.В5: Требуется ли для этого процесса чистое помещение?
А5:Хотя это и не является обязательным, интеграция в чистые помещения рекомендуется для поддержания чистоты подложки и повышения выхода годных изделий во время высокоточных операций.
О нас
Компания XKH специализируется на высокотехнологичной разработке, производстве и продаже специального оптического стекла и новых кристаллических материалов. Наша продукция используется в оптической электронике, бытовой электронике и военной промышленности. Мы предлагаем сапфировые оптические компоненты, защитные крышки для объективов мобильных телефонов, керамику, LT, карбид кремния (SIC), кварц и полупроводниковые кристаллические пластины. Благодаря высококвалифицированным специалистам и современному оборудованию мы преуспеваем в обработке нестандартной продукции, стремясь стать ведущим высокотехнологичным предприятием в области оптоэлектронных материалов.










