Оборудование для лазерной отводной съемки полупроводниковых лазеров
Подробная схема


Обзор продукции: оборудование для лазерной отводки
Оборудование для лазерного отслаивания полупроводниковых материалов представляет собой решение нового поколения для усовершенствованного утонения слитков в процессах обработки полупроводниковых материалов. В отличие от традиционных методов нарезки пластин, основанных на механической шлифовке, алмазной проволочной пиле или химико-механической полировке, эта лазерная платформа предлагает бесконтактную, неразрушающую альтернативу для отделения сверхтонких слоев от объемных полупроводниковых слитков.
Оборудование для лазерной резки полупроводниковых материалов, оптимизированное для работы с хрупкими и дорогостоящими материалами, такими как нитрид галлия (GaN), карбид кремния (SiC), сапфир и арсенид галлия (GaAs), позволяет осуществлять точную нарезку пленок размером с пластину непосредственно из кристаллического слитка. Эта прорывная технология значительно сокращает отходы материала, повышает производительность и улучшает целостность подложки — все это имеет решающее значение для устройств следующего поколения в силовой электронике, радиочастотных системах, фотонике и микродисплеях.
Оборудование для лазерной обработки полупроводниковых материалов, ориентированное на автоматизированное управление, формирование луча и анализ взаимодействия лазера с материалом, разработано для бесшовной интеграции в рабочие процессы производства полупроводников, обеспечивая при этом гибкость НИОКР и масштабируемость массового производства.

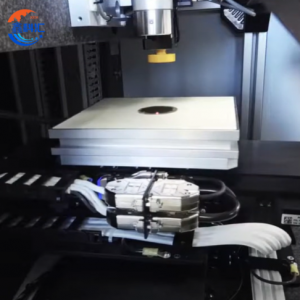
Технология и принцип работы лазерного подъемного оборудования
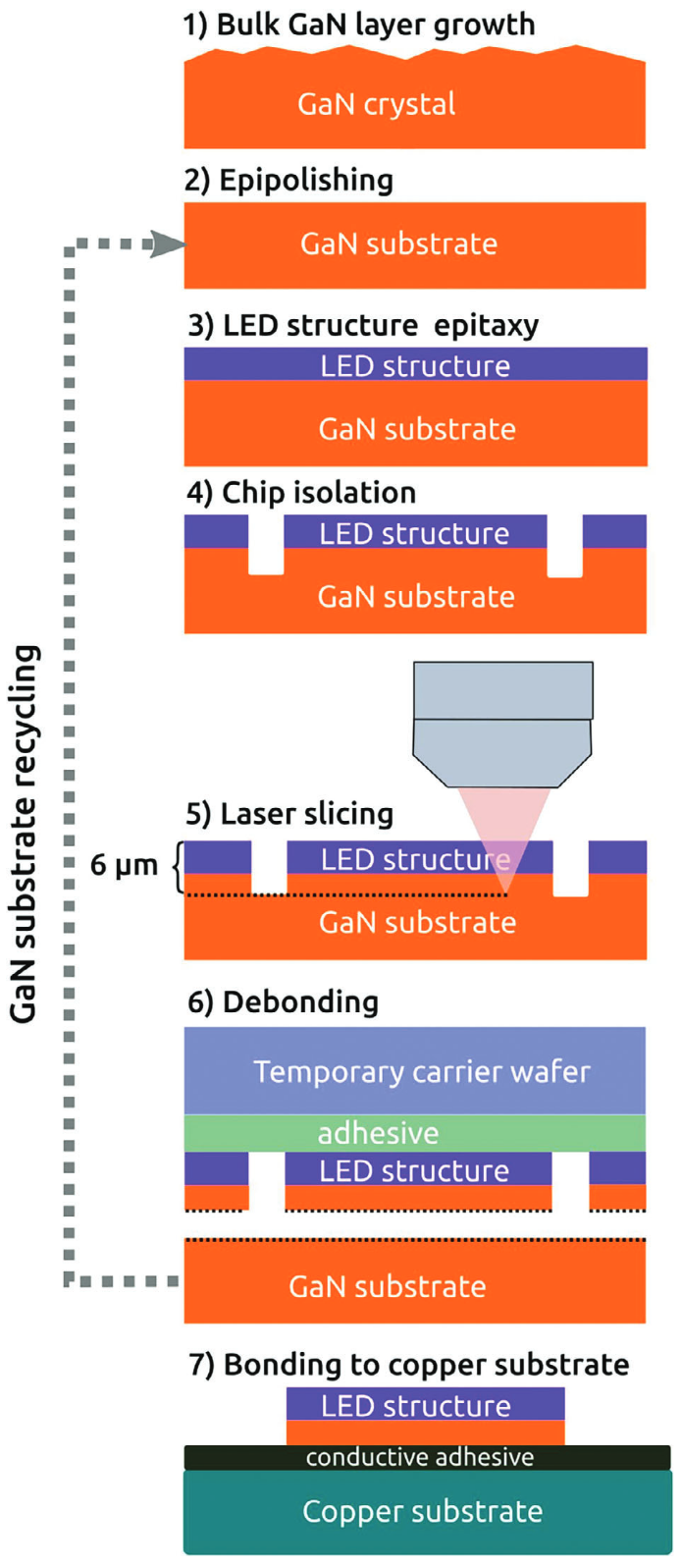
Процесс, выполняемый с помощью оборудования для лазерной подгонки полупроводниковых материалов, начинается с облучения донорского слитка с одной стороны высокоэнергетическим ультрафиолетовым лазерным лучом. Этот луч плотно фокусируется на определенной внутренней глубине, как правило, вдоль заданной границы раздела, где поглощение энергии максимально за счет оптического, теплового или химического контраста.
В этом слое поглощения энергии локальный нагрев приводит к быстрому микровзрыву, расширению газа или разложению межфазного слоя (например, пленки, создающей напряжение, или жертвенного оксида). Это точно контролируемое разрушение приводит к чистому отделению верхнего кристаллического слоя толщиной в десятки микрометров от базового слитка.
Оборудование для лазерной обработки полупроводниковых материалов использует синхронизированные по движению сканирующие головки, программируемое управление по оси Z и рефлектометрию в реальном времени, чтобы гарантировать точную передачу энергии каждым импульсом в целевую плоскость. Оборудование также может быть сконфигурировано с возможностью пакетной или многоимпульсной обработки для повышения плавности отслоения и минимизации остаточных напряжений. Важно отметить, что поскольку лазерный луч никогда не контактирует с материалом физически, риск микротрещин, деформации или сколов поверхности значительно снижается.
Это делает метод лазерного утонения революционным, особенно в тех областях применения, где требуются сверхплоские, сверхтонкие пластины с субмикронным изменением общей толщины (TTV).
Параметры оборудования для лазерной отводной обработки полупроводниковых лазеров
| Длина волны | ИК/SHG/THG/FHG |
|---|---|
| Ширина импульса | Наносекунда, пикосекунда, фемтосекунда |
| Оптическая система | Стационарная оптическая система или гальванооптическая система |
| XY-платформа | 500 мм × 500 мм |
| Диапазон обработки | 160 мм |
| Скорость передвижения | Максимальная скорость 1000 мм/сек. |
| Повторяемость | ±1 мкм или менее |
| Абсолютная точность позиционирования: | ±5 мкм или менее |
| Размер вафли | 2–6 дюймов или на заказ |
| Контроль | Windows 10, 11 и ПЛК |
| Напряжение питания | Переменный ток 200 В ±20 В, однофазный, 50/60 кГц |
| Внешние размеры | 2400 мм (Ш) × 1700 мм (Г) × 2000 мм (В) |
| Масса | 1000 кг |
Промышленное применение оборудования для лазерного отрыва
Оборудование для лазерной обработки полупроводниковых материалов быстро меняет подходы к подготовке материалов в различных областях полупроводниковой промышленности:
- Вертикальные силовые GaN-устройства, используемые в лазерном лифтинг-оборудовании.
Отделение сверхтонких пленок GaN-на-GaN от объемных слитков позволяет создавать вертикальные проводящие архитектуры и повторно использовать дорогостоящие подложки.
- Уменьшение толщины кремниевых пластин для диодов Шоттки и МОП-транзисторов.
Уменьшает толщину слоя устройства, сохраняя при этом плоскостность подложки — идеально подходит для быстродействующей силовой электроники.
- Материалы для светодиодов и дисплеев на основе сапфира, используемые в оборудовании для лазерного отрыва
Обеспечивает эффективное отделение слоев устройства от сапфировых слитков для поддержки производства тонких, термически оптимизированных микро-светодиодов.
- Материаловедение III-V групп в оборудовании для лазерного отрыва
Облегчает отделение слоев GaAs, InP и AlGaN для усовершенствованной оптоэлектронной интеграции.
- Изготовление тонкопленочных интегральных схем и датчиков
Позволяет создавать тонкие функциональные слои для датчиков давления, акселерометров или фотодиодов, где узким местом в производительности является объемный материал.
- Гибкая и прозрачная электроника
Создает сверхтонкие подложки, пригодные для гибких дисплеев, носимых схем и прозрачных «умных» окон.
В каждой из этих областей оборудование для лазерной обработки полупроводников играет решающую роль, обеспечивая миниатюризацию, повторное использование материалов и упрощение технологических процессов.

Часто задаваемые вопросы (FAQ) об оборудовании для лазерной оттяжки
В1: Какова минимальная толщина, которую я могу получить с помощью оборудования для лазерной подгонки полупроводниковых материалов?
А1:Как правило, толщина составляет от 10 до 30 микрон в зависимости от материала. При использовании модифицированного оборудования можно получить более тонкие образцы.
В2: Можно ли использовать это для нарезки нескольких пластин из одного слитка?
А2:Да. Многие клиенты используют технологию лазерного отслаивания для последовательного извлечения нескольких тонких слоев из одного цельного слитка.
В3: Какие меры безопасности предусмотрены для работы с мощным лазером?
А3:Корпуса класса 1, системы блокировки, экранирование от лучей и автоматическое отключение являются стандартными функциями.
Вопрос 4: Как эта система соотносится с алмазными проволочными пилами по стоимости?
A4:Хотя первоначальные капитальные затраты могут быть выше, лазерная обработка значительно снижает стоимость расходных материалов, повреждение подложки и этапы постобработки, что в долгосрочной перспективе уменьшает общую стоимость владения (TCO).
В5: Можно ли масштабировать этот процесс до слитков размером 6 или 8 дюймов?
А5:Безусловно. Платформа поддерживает подложки размером до 12 дюймов с равномерным распределением луча и крупноформатными подвижными платформами.
О нас
Компания XKH специализируется на высокотехнологичной разработке, производстве и продаже специального оптического стекла и новых кристаллических материалов. Наша продукция используется в оптической электронике, бытовой электронике и военной промышленности. Мы предлагаем сапфировые оптические компоненты, защитные крышки для объективов мобильных телефонов, керамику, LT, карбид кремния (SIC), кварц и полупроводниковые кристаллические пластины. Благодаря высококвалифицированным специалистам и современному оборудованию мы преуспеваем в обработке нестандартной продукции, стремясь стать ведущим высокотехнологичным предприятием в области оптоэлектронных материалов.











