В 1965 году сооснователь Intel Гордон Мур сформулировал то, что впоследствии стало «законом Мура». Более полувека он лежал в основе неуклонного роста производительности интегральных схем и снижения их стоимости — фундамента современных цифровых технологий. Вкратце: количество транзисторов на чипе примерно удваивается каждые два года.
Долгие годы прогресс следовал этому ритму. Теперь ситуация меняется. Дальнейшее уменьшение размеров стало затруднительным; размеры элементов сократились до нескольких нанометров. Инженеры сталкиваются с физическими ограничениями, более сложными технологическими этапами и ростом затрат. Меньшие геометрические размеры также снижают выход годной продукции, что затрудняет крупномасштабное производство. Создание и эксплуатация передового завода требует огромных капиталовложений и опыта. Поэтому многие утверждают, что закон Мура теряет свою силу.
Этот сдвиг открыл двери для нового подхода: чиплетной архитектуры.
Чиплет — это небольшой кристалл, выполняющий определенную функцию, по сути, часть того, что раньше представляло собой монолитный чип. Интегрируя несколько чиплетов в один корпус, производители могут собрать полноценную систему.
В эпоху монолитных систем все функции размещались на одном большом кристалле, поэтому любой дефект мог привести к поломке всего чипа. В случае с чиплетами системы строятся из «заведомо исправных кристаллов» (KGD), что значительно повышает выход годной продукции и эффективность производства.
Гетерогенная интеграция — объединение кристаллов, созданных на разных технологических процессах и для выполнения различных функций, — делает чиплетные архитектуры особенно мощными. Высокопроизводительные вычислительные блоки могут использовать новейшие технологии, в то время как память и аналоговые схемы остаются на основе зрелых, экономически эффективных технологий. Результат: более высокая производительность при более низкой стоимости.
Автомобильная промышленность проявляет особый интерес. Крупные автопроизводители используют эти технологии для разработки будущих автомобильных SoC, массовое внедрение которых планируется после 2030 года. Чиплеты позволяют более эффективно масштабировать ИИ и графику, одновременно повышая выход годной продукции, что улучшает как производительность, так и функциональность автомобильных полупроводников.
Некоторые автомобильные компоненты должны соответствовать строгим стандартам функциональной безопасности и поэтому используют более старые, проверенные технологические процессы. В то же время современные системы, такие как усовершенствованные системы помощи водителю (ADAS) и программно-определяемые транспортные средства (SDV), требуют гораздо больших вычислительных мощностей. Чиплеты заполняют этот пробел: объединяя микроконтроллеры класса безопасности, большой объем памяти и мощные ускорители искусственного интеллекта, производители могут быстрее адаптировать SoC к потребностям каждого автопроизводителя.
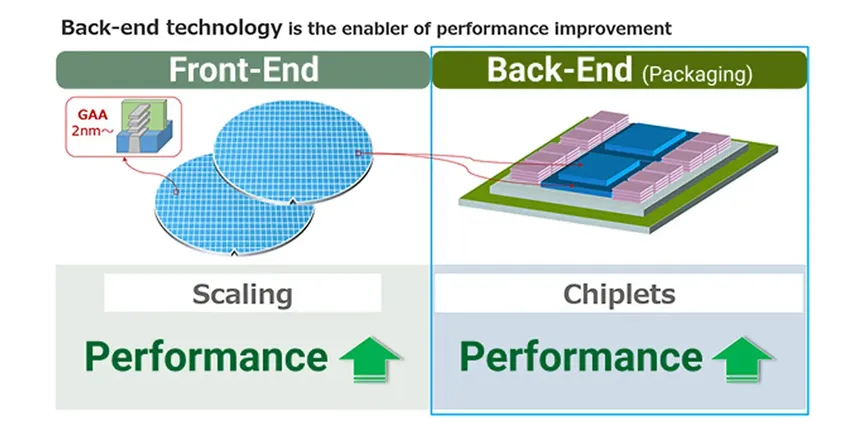
Эти преимущества выходят за рамки автомобильной промышленности. Чиплетные архитектуры распространяются в области искусственного интеллекта, телекоммуникаций и других сферах, ускоряя инновации во всех отраслях и быстро становясь одним из ключевых элементов стратегии развития полупроводниковой промышленности.
Интеграция микросхем зависит от компактных и высокоскоростных соединений между кристаллами. Ключевым фактором является интерпозер — промежуточный слой, часто кремниевый, расположенный под кристаллами, который передает сигналы подобно миниатюрной печатной плате. Более качественные интерпозеры обеспечивают более тесную связь и более быстрый обмен сигналами.
Усовершенствованная компоновка также улучшает передачу питания. Плотные массивы крошечных металлических соединений между кристаллами обеспечивают достаточные пути для тока и данных даже в ограниченном пространстве, что позволяет осуществлять высокоскоростную передачу данных при эффективном использовании ограниченной площади корпуса.
Сегодня наиболее распространенный подход — это 2.5D интеграция: размещение нескольких кристаллов рядом друг с другом на межсоединительной подложке. Следующий шаг — это 3D интеграция, при которой кристаллы располагаются вертикально друг над другом с использованием сквозных кремниевых соединений (TSV) для еще большей плотности размещения.

Сочетание модульной конструкции микросхем (разделение функций и типов схем) с трехмерной компоновкой позволяет создавать более быстрые, компактные и энергоэффективные полупроводниковые устройства. Совместное размещение памяти и вычислительных ресурсов обеспечивает огромную пропускную способность для больших наборов данных — идеально подходит для искусственного интеллекта и других высокопроизводительных задач.
Однако вертикальное наслаивание создает проблемы. Тепло накапливается быстрее, что усложняет управление тепловыми процессами и снижает выход годной продукции. Для решения этой проблемы исследователи разрабатывают новые методы упаковки, позволяющие лучше справляться с тепловыми ограничениями. Тем не менее, тенденция набирает обороты: конвергенция чиплетов и 3D-интеграции широко рассматривается как революционная парадигма, готовая подхватить эстафету там, где заканчивается действие закона Мура.
Дата публикации: 15 октября 2025 г.
